
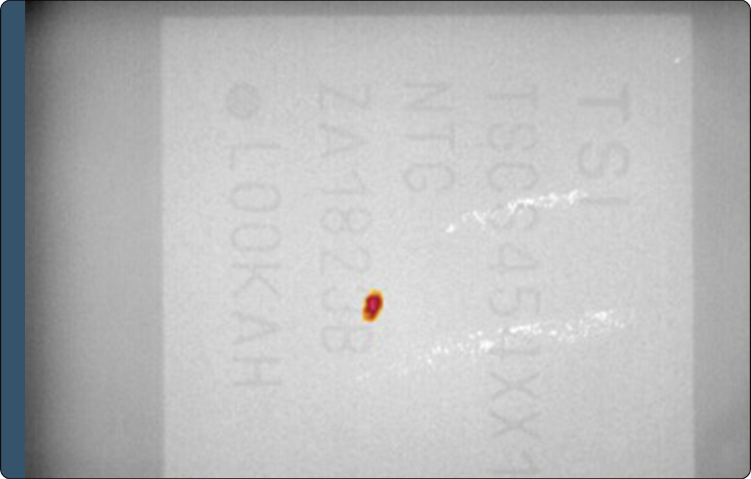







2025-09-20 05:24:34
作為專為半導(dǎo)體檢測(cè)設(shè)計(jì)的紅外熱點(diǎn)顯微鏡,它兼具高頻、高靈敏度與高分辨率優(yōu)勢(shì)。通過周期性電信號(hào)激勵(lì)與相位分析,紅外熱點(diǎn)顯微鏡能實(shí)時(shí)提取微弱紅外光譜信號(hào),檢測(cè)mK級(jí)溫度變化——這意味著即使是芯片內(nèi)部0.1mK的微小溫差,紅外熱點(diǎn)顯微鏡也能捕捉,輕松定位內(nèi)部發(fā)熱缺陷的深度與分布。紅外熱點(diǎn)顯微鏡的無損檢測(cè)能力尤為突出。無需破壞器件,紅外熱點(diǎn)顯微鏡就能檢測(cè)功率半導(dǎo)體及IGBT缺陷,涵蓋電源電路缺陷、電流泄漏等問題,為器件設(shè)計(jì)優(yōu)化與良率提升提供數(shù)據(jù)支撐。同時(shí),紅外熱點(diǎn)顯微鏡適配“設(shè)備-算法-應(yīng)用場(chǎng)景”一體化思路,不僅滿足檢測(cè)精度,更適配產(chǎn)業(yè)效率需求。通過接收樣品自身發(fā)射的熱紅外輻射,經(jīng)光學(xué)系統(tǒng)聚焦后轉(zhuǎn)化為電信號(hào),實(shí)現(xiàn)樣品熱分布分析。半導(dǎo)體失效分析熱紅外顯微鏡原理

熱紅外顯微鏡在半導(dǎo)體IC裸芯片的熱檢測(cè)中具有不可替代的作用。裸芯片內(nèi)部結(jié)構(gòu)高度精密、集成度極高,即便是微小的熱異常,也可能影響性能甚至引發(fā)失效,因此精確的熱檢測(cè)至關(guān)重要。
依托非接觸式成像原理,熱紅外顯微鏡能夠清晰呈現(xiàn)芯片工作過程中的熱分布與溫度變化,快速定位熱點(diǎn)區(qū)域。這些熱點(diǎn)往往源于電路設(shè)計(jì)缺陷、局部電流過大或器件老化等問題。通過對(duì)熱點(diǎn)檢測(cè)與分析,工程師能夠及時(shí)發(fā)現(xiàn)潛在故障風(fēng)險(xiǎn),為優(yōu)化芯片設(shè)計(jì)和改進(jìn)制造工藝提供有力依據(jù)。
此外,熱紅外顯微鏡還能精確測(cè)量裸芯片內(nèi)部關(guān)鍵半導(dǎo)體結(jié)點(diǎn)的溫度(結(jié)溫)。結(jié)溫是評(píng)估芯片性能與可靠性的重要指標(biāo),過高的結(jié)溫不僅會(huì)縮短器件壽命,還可能影響其長期穩(wěn)定性。憑借高空間分辨率的成像能力,該技術(shù)能夠?yàn)檠邪l(fā)人員提供詳盡的熱特性數(shù)據(jù),幫助制定高效的散熱方案,從而提升芯片的整體性能與可靠性。 半導(dǎo)體失效分析熱紅外顯微鏡原理熱紅外顯微鏡成像:可疊加光學(xué)顯微圖像,實(shí)現(xiàn) “熱 - 光” 關(guān)聯(lián)分析,明確樣品熱異常對(duì)應(yīng)的微觀結(jié)構(gòu)。

無損熱紅外顯微鏡的非破壞性分析(NDA)技術(shù),為失效分析提供了 “保全樣品” 的重要手段。它在不損傷高價(jià)值樣品的前提下,捕捉隱性熱信號(hào)以定位內(nèi)部缺陷,既保障了分析的準(zhǔn)確性,又為后續(xù)驗(yàn)證、復(fù)盤保留了完整樣本,讓失效分析從 “找到問題” 到 “解決問題” 的閉環(huán)更高效、更可靠。相較于無損熱紅外顯微鏡的非侵入式檢測(cè),這些有損分析方法雖能獲取內(nèi)部結(jié)構(gòu)信息,但會(huì)破壞樣品完整性,更適合無需保留樣品的分析場(chǎng)景,與無損分析形成互補(bǔ)!
在電子設(shè)備運(yùn)行過程中,當(dāng)某個(gè)元件出現(xiàn)故障或異常時(shí),通常會(huì)伴隨局部溫度升高。熱紅外顯微鏡能夠通過高靈敏度的紅外探測(cè)器捕捉到這些極其微弱的熱輻射信號(hào),從而實(shí)現(xiàn)對(duì)故障元件的定位。這些探測(cè)器通常采用量子級(jí)聯(lián)激光器或其他高性能紅外傳感方案,具備寬溫區(qū)適應(yīng)性和高分辨率成像能力。借助這些技術(shù),熱紅外顯微鏡能夠?qū)㈦娮釉O(shè)備表面的溫度分布轉(zhuǎn)化為高對(duì)比度的熱圖像,直觀呈現(xiàn)熱點(diǎn)區(qū)域的位置、尺寸及溫度變化趨勢(shì)。工程師可以通過對(duì)這些熱圖像的分析,快速識(shí)別異常發(fā)熱區(qū)域,判斷潛在故障點(diǎn)的性質(zhì)與嚴(yán)重程度,從而為后續(xù)的維修、優(yōu)化設(shè)計(jì)或工藝改進(jìn)提供可靠依據(jù)。得益于非接觸式測(cè)量和高精度成像能力,熱紅外顯微鏡在復(fù)雜集成電路、高性能半導(dǎo)體器件及精密印制電路板等多種電子組件的故障排查中,提升了效率和準(zhǔn)確性,成為現(xiàn)代電子檢測(cè)和失效分析的重要工具。熱紅外顯微鏡成像儀支持實(shí)時(shí)動(dòng)態(tài)成像,能記錄樣品在不同環(huán)境下的溫度分布動(dòng)態(tài)變化過程。

在半導(dǎo)體產(chǎn)業(yè)加速國產(chǎn)化的浪潮中,致晟光電始終錨定半導(dǎo)體失效分析這一**領(lǐng)域,以技術(shù)創(chuàng)新突破進(jìn)口設(shè)備壟斷,為國內(nèi)半導(dǎo)體企業(yè)提供高性價(jià)比、高適配性的檢測(cè)解決方案。不同于通用型檢測(cè)設(shè)備,致晟光電的產(chǎn)品研發(fā)完全圍繞半導(dǎo)體器件的特性展開 —— 針對(duì)半導(dǎo)體芯片尺寸微小、缺陷信號(hào)微弱、檢測(cè)環(huán)境嚴(yán)苛的特點(diǎn),其光發(fā)射顯微鏡整合了高性能 InGaAs 近紅外探測(cè)器、精密顯微光學(xué)系統(tǒng)與先進(jìn)信號(hào)處理算法,可在芯片通電運(yùn)行狀態(tài)下,精細(xì)捕捉異常電流產(chǎn)生的微弱熱輻射,高效定位從裸芯片到封裝器件的各類電學(xué)缺陷。熱紅外顯微鏡范圍:探測(cè)波長通常覆蓋 2-25μm 的中長波紅外區(qū)域,適配多數(shù)固體、液體樣品的熱輻射特性。熱紅外顯微鏡與光學(xué)顯微鏡對(duì)比
熱紅外顯微鏡探測(cè)器:非制冷微測(cè)輻射熱計(jì)(Microbolometer)成本低,適用于常溫樣品的常規(guī)檢測(cè)。半導(dǎo)體失效分析熱紅外顯微鏡原理
微光紅外顯微儀是一種高靈敏度的失效分析設(shè)備,可在非破壞性條件下,對(duì)封裝器件及芯片的多種失效模式進(jìn)行精細(xì)檢測(cè)與定位。其應(yīng)用范圍涵蓋:芯片封裝打線缺陷及內(nèi)部線路短路、介電層(Oxide)漏電、晶體管和二極管漏電、TFT LCD面板及PCB/PCBA金屬線路缺陷與短路、ESD閉鎖效應(yīng)、3D封裝(Stacked Die)失效點(diǎn)深度(Z軸)預(yù)估、低阻抗短路(<10 Ω)問題分析,以及芯片鍵合對(duì)準(zhǔn)精度檢測(cè)。相比傳統(tǒng)方法,微光紅外顯微儀無需繁瑣的去層處理,能夠通過檢測(cè)器捕捉異常輻射信號(hào),快速鎖定缺陷位置,大幅縮短分析時(shí)間,降低樣品損傷風(fēng)險(xiǎn),為半導(dǎo)體封裝測(cè)試、產(chǎn)品質(zhì)量控制及研發(fā)優(yōu)化提供高效可靠的技術(shù)手段。半導(dǎo)體失效分析熱紅外顯微鏡原理